設備紹介
集束イオンビーム装置(FIB)
保有装置型式

Helios5 CX
サーモフィッシャー
サイエンティフィック社製
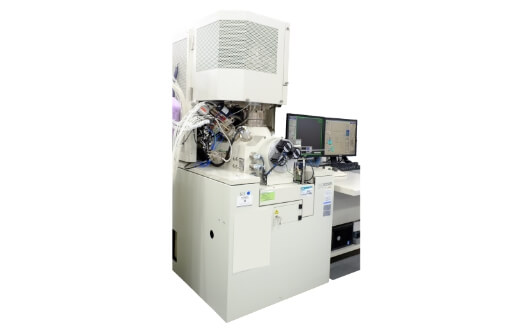
SMI3050R 日立ハイテク社製
弊社の機能
POINT
135年を超えるFIB配線修正、断面加工の実績により、高度な技術と確かな信頼を得ています。
POINT
2短納期で高品質な技術をご提供します。
機能
断面作製・観察/元素分析
- FIBによる断面作製からFE-SEMによる断面観察までをシームレスで可能。また、EDSによる元素分析も可能
- 半導体・エレクトロニクス・自動車・鉄鋼・エネルギーなど様々なサンプルに対応
- セラミック、有機物などの絶縁物への加工も可能(*要相談)
配線修正
- 豊富なデポジション膜(Pt、W、C、絶縁膜)
- 6インチウェハ搬入可能(ウエハー中央部のみ加工可能)
- Cu配線への加工対応
- アシストガスを用いた選択エッチング加工(XeF、有機膜用ガス)
- 帯電防止機能(チャージニュートライザー)付き
微小構造物作製
- 立体構造物の作製経験が豊富
- エッチングとデポジションの両方で作製可能
- 自由形状での加工が可能
TEM用薄片試料作製
- マイクロサンプリング法、リフトアウト法等、ご要望により様々な方法で薄片を作製
- 低加速加工による低ダメージ薄片試料の作製
Slice&View
- 連続加工/観察により取得した断面観察像を再構築することで、立体的な構造情報を得ることが可能。
- 元素分析、3D解析ソフトウェアにより詳細解析も可能。
原理と仕様
原理
集束イオンビーム(Focused Ion Beam:FIB)装置は、集束したイオンビームを試料に照射し、加工や観察を行う装置です。また、FIB-SEMは高解像度のFE-SEM(電界放出形電子顕微鏡)を搭載しており、高分解能での観察と加工が同時に行えるのが特徴です。
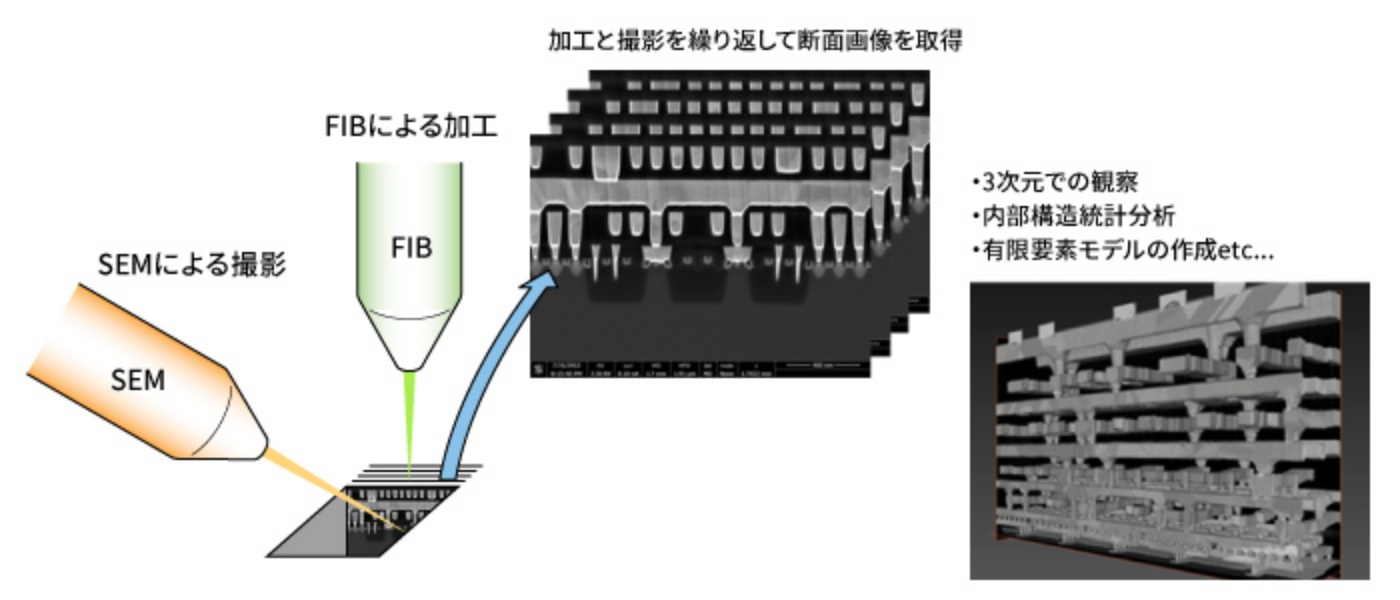
仕様
| FIB | Gaイオン源 加速0.5~30kV |
|---|---|
| FE- SEM | 加速0.2~30kV |
| 試料サイズ | 110mm×110mm×65mm (最大6インチΦウエハ搬入可能) |
走査型プローブ顕微鏡(SPM/AFM)
保有装置型式

E-Sweep環境制御型ユニット/プローブステーションAFM5000Ⅱ
日立ハイテク社製
特徴
環境制御測定(温度可変、電圧印加、真空)
- 試料温度可変:-120℃~300℃
- 試料印加電圧:最大±100【V】
物性モード
- 様々なオプションに対応
AFM、DFM、導電性(Nano/Pico Current AFM)、表面電位・静電気力(KFM、EFM)、圧電変位(PRM)、LM-FFM(横振動摩擦力)、弾性率(SIS-ACCESS・QuantiMech)など
ハイアスペクト形状・物性測定(SISモード)
- ハイアスペクトカンチレバー及びSISモードを用いた測定
- 試料表面の影響(大きな凹凸、吸着、静電気等)を軽減させ安定した高精度測定が可能
平滑な試料面の作製(前処理技術)
- イオンミリング断面加工、クライオウルトラミクロトーム加工
弊社の特長
POINT
1多岐に渡るサンプル、物性モードの測定実績を有しています。
POINT
2高度な技術と確かな信頼を得ています。
原理と仕様
原理
走査型プローブ顕微鏡(Scanning Probe Microscope:SPM)とは、探針と試料表面の間に働く様々な物理的相互作用を検出し、微少領域の表面形状観察、電気・機械物性計測を行う顕微鏡の総称です。
原子間力顕微鏡(Atomic Force Microscope:AFM)は、探針と試料に作用する原子間力を検出するタイプの顕微鏡です。AFM探針は片持ちバネ(カンチレバー)の先端に取り付けられていて、この探針と試料表面を微小な力で接触させ、カンチレバーのたわみ量が一定になるように探針・試料間距離(Z)をフィードバック制御しながら水平(X、Y)に走査することで、表面形状を画像化します。カンチレバー種類や検出信号を変えることにより様々な物性測定が可能となります。
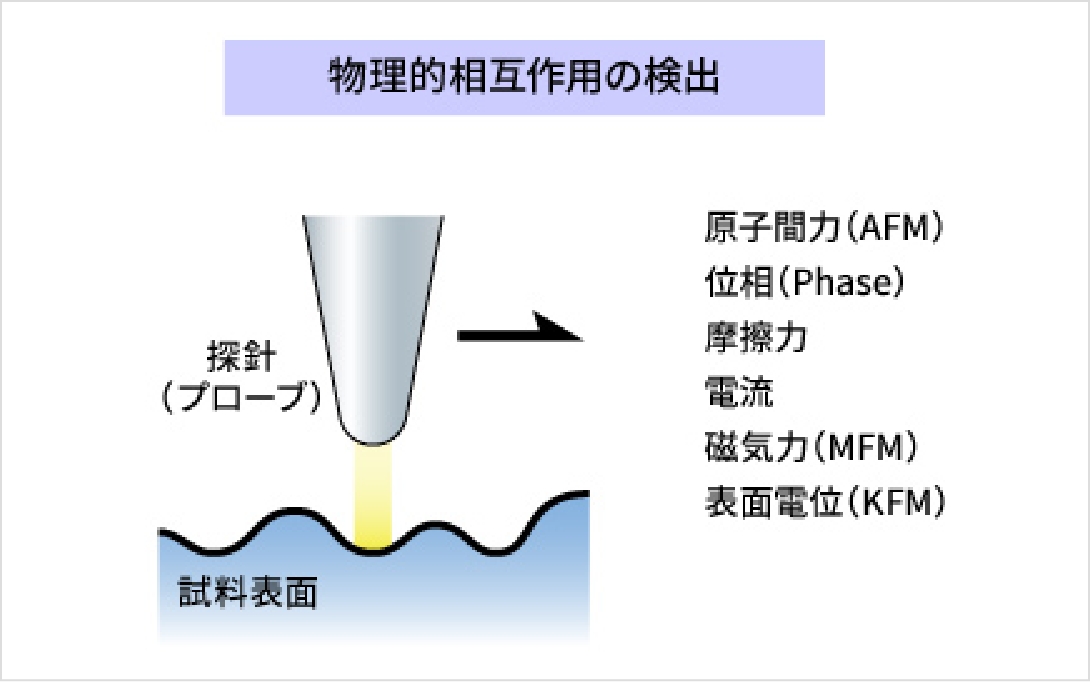
SPMの概要
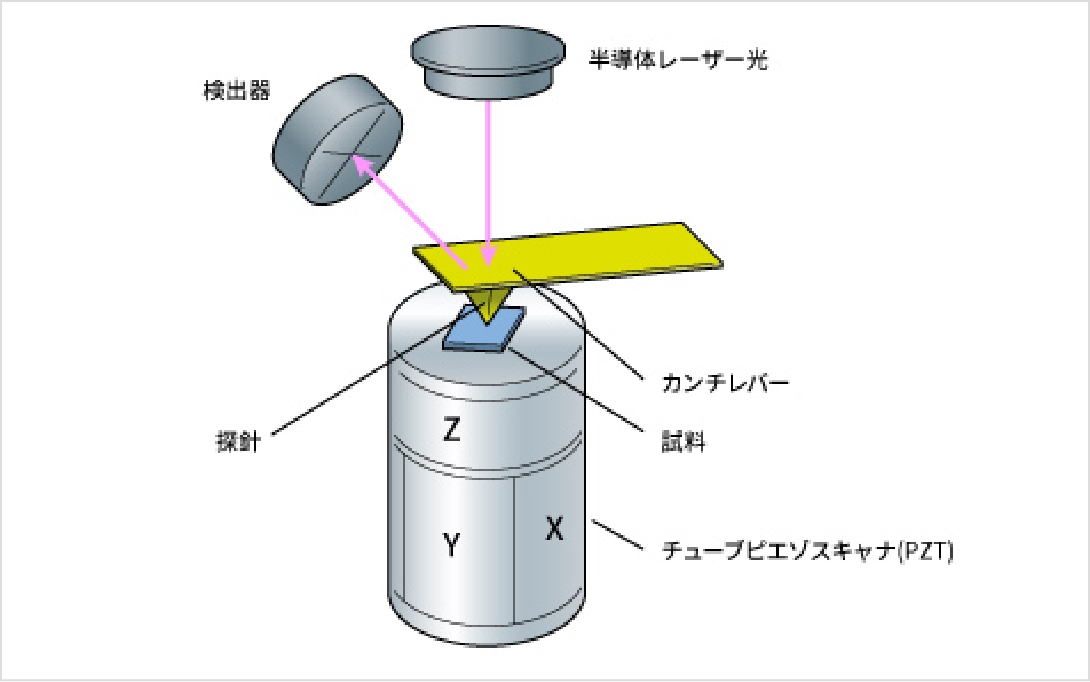
SPMの基本構成
仕様
| 試料サイズ | 外形:25mmΦ以下 厚さ:8mm以下 |
|---|---|
| 測定範囲 | 20×20μm 領域(高低差1μm以内)※高分解能仕様 150×150μm 領域(高低差5μm以内) |
| 測定モード | 形状:AFM、DFM、SISモード 物質:導電性(Nano/Pico Current AFM)、表⾯電位‧静電気⼒(KFM、EFM)、圧電変位(PRM)、LM-FFM(横振動摩擦⼒)、弾性率(SIS-ACCESS‧QuantiMech)など 環境制御:温度-120℃~300℃、電圧印加 最大±100V、真空 |
熱分析(TA)
保有装置型式

DSC
DSC600(メーカー最新機種、生体試料用大容量容器対応)
日立ハイテクサイエンス社製

TG-DSC
STA300(メーカー最新機種)
日立ハイテクサイエンス社製

TG-DTA7300(減圧測定対応)
日立ハイテクサイエンス社製

TMA:TMA/SS6100/6300
日立ハイテクサイエンス社製

DMA
DMS6100
日立ハイテクサイエンス社製
特徴
高温対応 最大1500℃
- DSC、TG/DTA、TMAモードにて対応
- 高温比熱:温度変調DSC測定による高温比熱測定が可能(*要相談)
解析技術と技術コンサルティング
- 樹脂の硬化特性解析(シュミレーション):kamalモデル式からのパラメータ算出
- 長時間変形予測:マスターカーブからの長時間クリープ変形量予測
- 熱分析結果の速度論解析:劣化時間、反応率の推定
- 超高感度DSC測定:食品、化粧品、バイオ、医学・薬学関連試料の超高感度DSC測定の実績が豊富(*要相談)
熱分析の測定例
- DSC:試料の融解、結晶化、ガラス転移、熱硬化反応等の温度、比熱、熱量を測定
- TG/DTA:試料の酸化、熱分解、脱水等による重量変化、耐熱性の評価、反応速度論解析
- TMA:試料の膨張率、ガラス転移、軟化点の測定
- DMA:貯蔵弾性率、損失弾性率等、損失正接等の温度依存性、周波数依存性の測定
弊社の特長
POINT
1装置メーカーラボ出身分析技術者による
高い解析力を有しています。
原理と仕様
原理
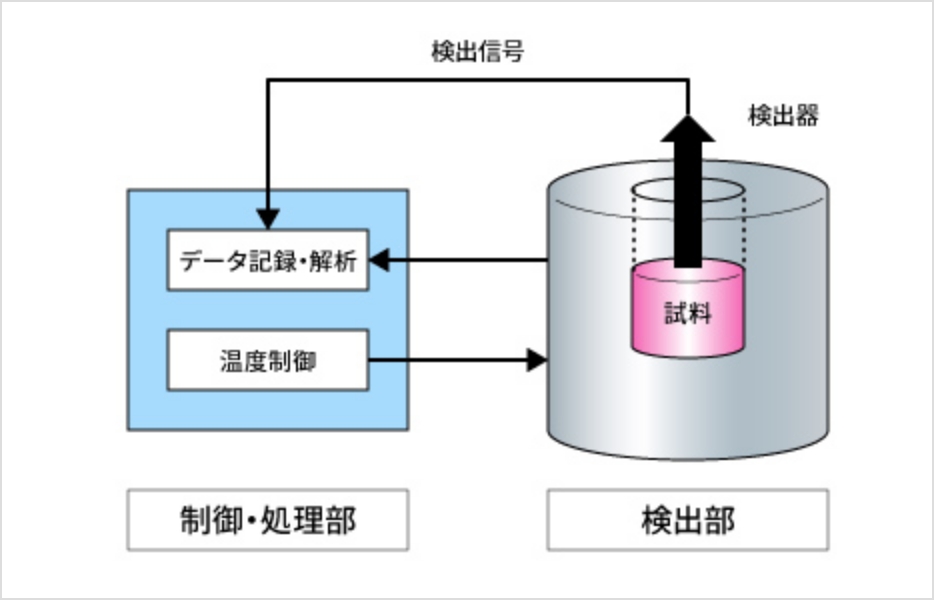
熱分析とは、物質の温度を一定のプログラムによって変化させながら、その物質のある物理的性質を温度の関数として測定する一連の技法の総称です。
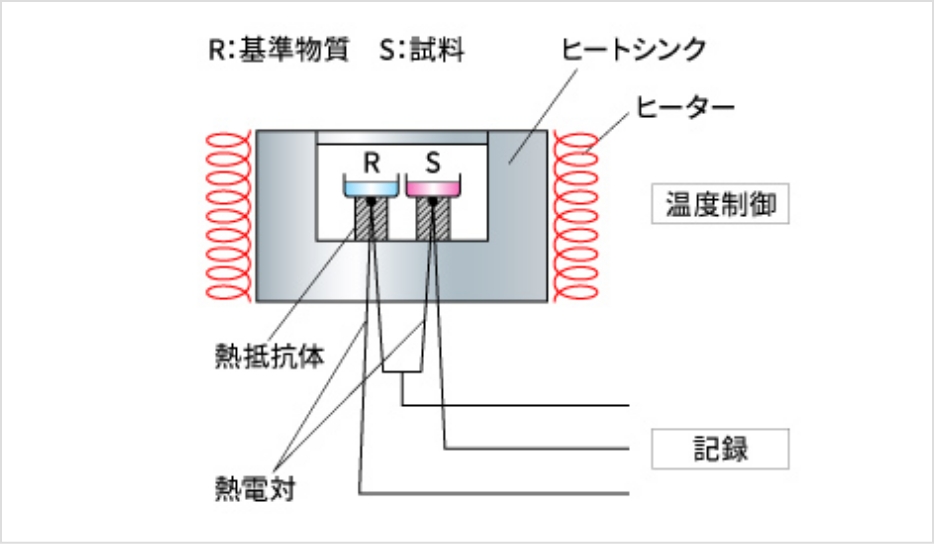
DSC(示差走査熱量測定)
DSC(示差走査熱量測定)は、次の二つの測定方法の総称となります。
・熱流束示差走査熱量測定(熱流束DSC)
試料及び基準物質で構成される試料部の温度を、一定のプログラムによって変化させながら、その試料と基準物質との温度差を、温度の関数として測定する方法。この温度差は、単位時間当たりの熱エネルギーの入力差に比例する。
・入力補償示差走査熱量測定(入力補償DSC)
試料及び基準物質で構成される試料部の温度を、一定のプログラムによって変化させながら、その試料及び基準物質の温度が等しくなるように、両者に加えた単位時間当たりの熱エネルギーの入力差を温度の関数として測定する方法。
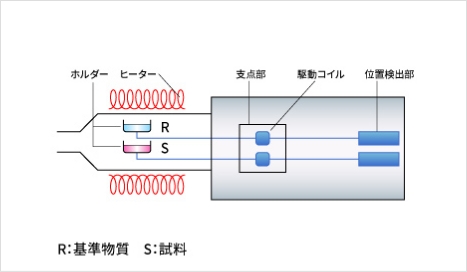
TG(示差熱・熱重量同時測定)
TG(示差熱・熱重量同時測定)とは、試料及び基準物質の温度をプログラムに従って変化させながら、試料の重量変化 測定(TG)及び試料と基準物質の温度差を測定する示差熱測定(DTA)を同時に行う手法です。 試料の水分量、灰分量測定や分解、酸化、耐熱性などの物性評価が可能です。
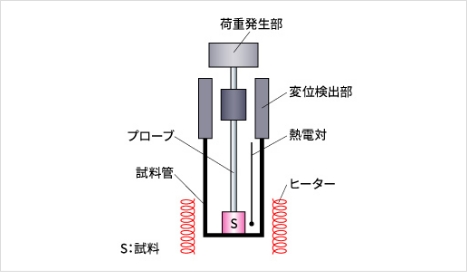
TMA(熱機械分析)
TMA(熱機械分析)は試料に非振動的荷重(一定荷重)をかけながらの温度に対する変形を計測する手法である。 荷重の与え方として、圧縮、引張り、曲げ等の種類がある。
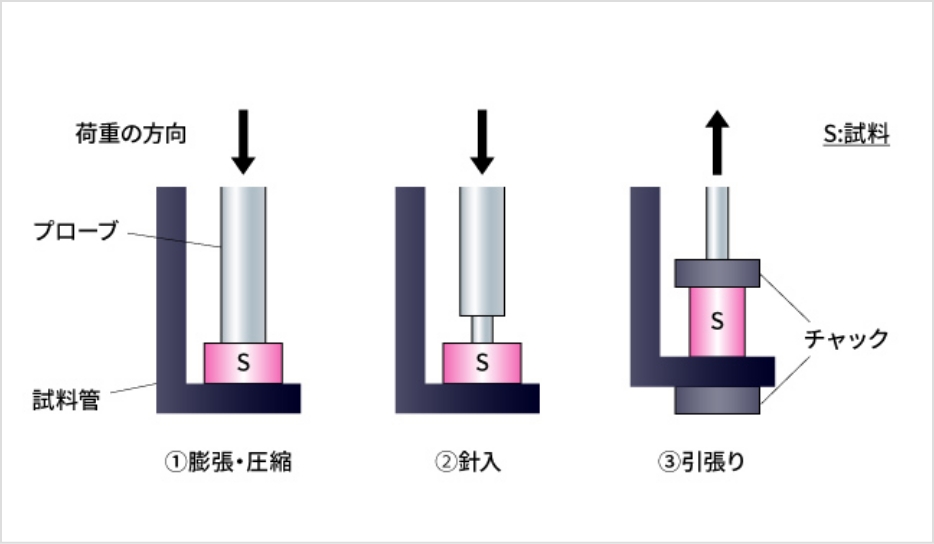
TMAでは計測目的によって試料への荷重のかけ方を変えるため以下プローブがあり、
測定の目的に応じて選択している。
①膨張・圧縮プローブ:試料に圧縮荷重をかけ、熱膨張や転移による形状変化を計測するためのプローブ
➁針入プローブ:圧縮プローブの先端に針状の細い突起を設け、試料に局部的に大きな荷重をかけ、軟化点を測定するためのプローブ
③引張りプローブ:試料に引張り荷重をかけ、熱膨張や熱収縮等を測定するためのプローブ
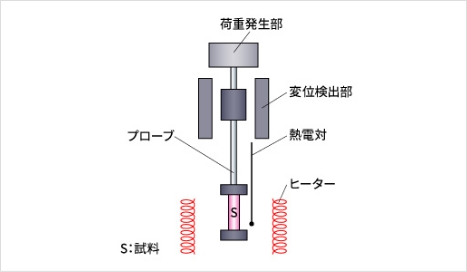
DMA(動的粘弾性測定)
DMA(動的粘弾性測定)は試料に時間によって変化(振動)する歪みまたは応力を与えて、それによって発生する応力または歪みを測定することにより、試料の力学的な性質を測定する方法。
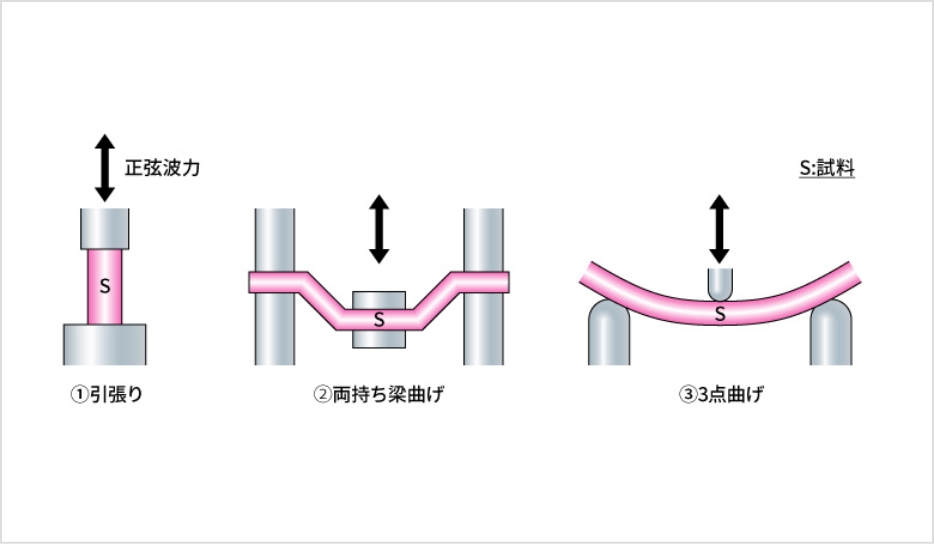
DMAは異なる変形モードを用いることにより、広範囲にわたる材料に適用することができる。以下変形モード用プローブがあり、試験片の形状や弾性率など測定目的に応じて選択している。
①引張り
➁両持ち梁曲げ
③3点曲げ
仕様
| 温度範囲 | DSC:-150℃~1500℃ 昇温速度:10℃/min(1000℃以上は、20℃/min) TG/DTA:室温~1500℃ 昇温速度:10℃/min(1000℃以上は、20℃/min) TMA:-150℃~1500℃ 昇温速度:3~5℃/min DMA:-100℃~400℃ 昇温速度:2℃/min *低昇温速度は別途ご相談下さい |
|---|---|
| 測定雰囲気 | 大気/N2/Ar |
| 試料量 | 測定モードにより、別途お問い合わせ下さい |
オージェ電子分光分析(AES)/X線光電子分光分析(XPS)
保有装置型式
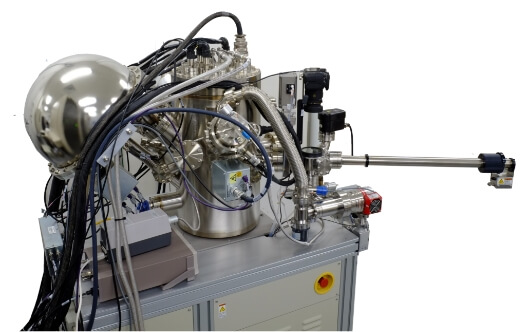
VersaProbeⅡ
アルバック・ファイ社製
特徴
面分析(マッピング)、深さ方向(デプス)分析が可能
AES/XPS複合装置のため、最大効率での多様なアプローチが可能
弊社の特長
POINT
1LaB6銃を備えており、1台の装置でAESとXPSの2つの使い方が可能です。
原理と仕様
原理

オージェ電子分光(AES)
オージェ電子分光(AES)は、超高真空下で細く絞った電子線を試料表面に照射し、放出されるオージェ電子の運動エネルギーを解析することで極表層(数nmほど)の組成を分析することが可能です。
X線光電子分光法(XPS)
X線光電子分光分析(XPS)は、試料表面にX線を照射し、放出される光電子の結合エネルギーから極表層の組成を分析することが可能です。
また、化学シフトから結合状態分析を行えることが大きな特徴です。
励起源として軟X線を用いているため試料損傷が小さく、帯電も容易に中和できるため、金属材料や高分子材料など多くの材料に対して測定が可能です。

構成図
仕様
| 試料サイズ | 外形:25mmΦ以下 厚さ:7mm以下 |
|---|---|
| 分析範囲 | AES:1μm以上 XPS:30μm以上 |
| 分析機能 | 定性分析、線分析、面分析、デプスプロファイル |
グロー放電発光分析装置(GD-OES)
保有装置型式

GD-Profiler2
堀場製作所製
特徴
スパッタリング速度が1~20 μm/minと高速であるため,深さ方向の分析を迅速に行うことができます。
高真空を必要としない装置で線光電子分光装置(XPS)やオージェ電子分光装置(AES)などの表面分析装置と比較すると,簡便に分析を行うことができます。
弊社の特長
POINT
1精密機械製造メーカーで培った分析力を有しています。
原理と仕様
原理
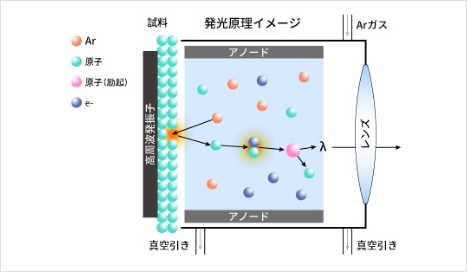
GD-OES(Glow discharge optical emission spectrometry )はAr グロー放電領域内で導電性、非導電性膜を高周波スパッタリングし、スパッタされた原子のAr プラズマ内における発光線を連続的に分光することにより、薄膜の深さ方向の元素分布を測定する手法である。
仕様
| 試料サイズ | 平板 φ100㎜程度 |
|---|---|
| 分析範囲 | 分析径φ4㎜、深さ~100μm |
| 分析機能 | 深さ方向の組成分析 |
透過電子顕微鏡(TEM、STEM、EDS)
保有装置型式

JEM-2800 日本電子社製
特徴
nmサイズの微細構造観察が可能
高精度な前処理技術
- FIBによる高い位置精度のサンプリング
- イオンスライサー前処理によるダメージレス試料の作製、高解像度のTEM像観察
装置内で試料を90度回転させることができ、ナノオーダーでの3次元構造や不良個所特定が可能
- 特殊治具の適用
STEM/EDS機能による物質の同定
弊社の特長
POINT
1半導体故障解析の実績が多数あります。
原理と仕様
原理
透過電子顕微鏡(TEM)は、電子線(平行ビーム)を試料に照射し、試料中を透過した電子を電磁レンズで結像し、高倍率で観察します。特に高分解能TEM法では、試料中を透過した電子と回折を起こした電子の両方を使って結像することで格子像の観察が可能です。
走査透過電子顕微鏡(STEM)は、サブナノメートルまで細く絞った電子プローブを試料上で走査させ、走査させた位置における散乱された電子を試料下部の各種検出器で収集し、電子プローブ走査と同期させることでモニタ上に観察像を形成する手法です。
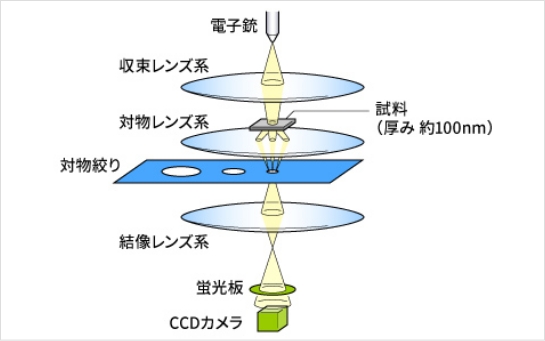
TEMの構成図
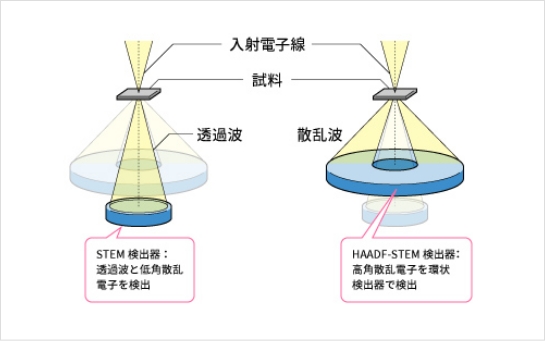
STEMの構成図
仕様
| 分析機能 | TEM観察、STEM観察、元素分析 |
|---|
クロスセクションポリッシャ断面加工(CP、イオンミリング)
保有装置型式

IB-09010CP 日本電子社製

IB-09020CP 日本電子社製

IM4000Plus 日立ハイテク社製
特徴
加工ダメージの少ない平滑面の作製が可能
試料冷却(クライオ)による
熱影響を低減した加工が可能
約1mmの領域で加工面を作製することが可能
弊社の特長
POINT
1精密機械製造メーカーで培った分析力を有しています。
原理と仕様
原理
クロスセクションポリッシャ(CP)は、主に走査電子顕微鏡(SEM)観察/分析のための断面試料作製装置です。この装置はブロードなAr(アルゴン)イオンビームと遮蔽(しゃへい)板を用いて試料の断面を加工する装置です。CPは金属、セラミックス、プラスチック等、様々な材料で断面加工をすることが可能であり、多方面において活用されています。
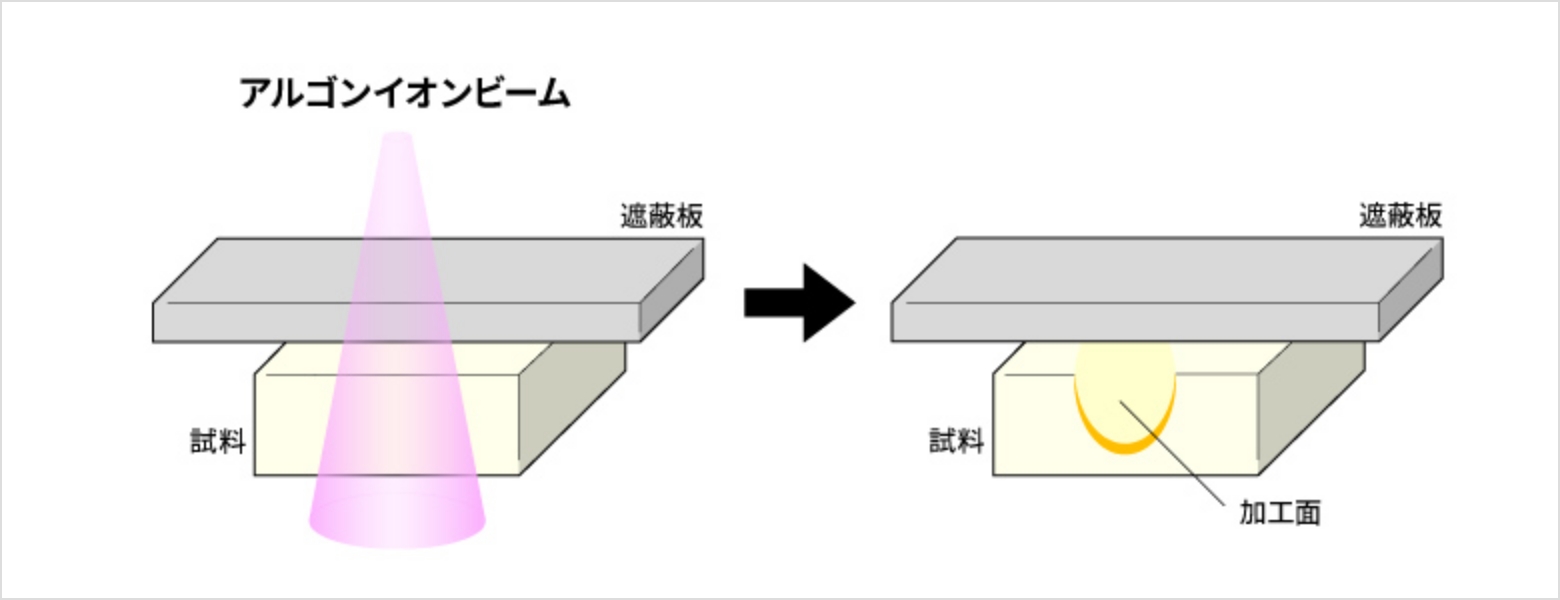
仕様
| 試料サイズ | 外形:8mm以内 厚さ:3mm以下 |
|---|---|
| 加工範囲 | 1mm程度 |
| 加工精度 | ±20μm |
走査電子顕微鏡(SEM)/電界放出形走査電子顕微鏡(FE-SEM)
保有装置型式
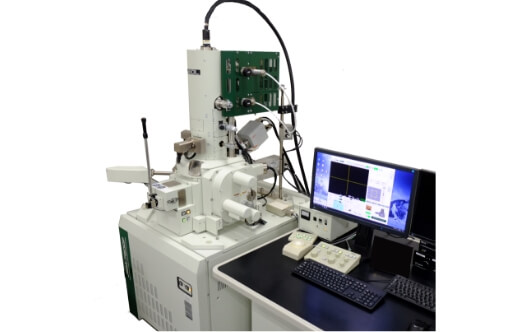
FE-SEM JSM-7800F/EDS
日本電子社製

FE-SEM JSM-7200F/EDS
日本電子社製
※低真空モード対応可

SEM TM3030Plus
日立ハイテク社製
特徴
微小な表面構造を鮮明に観察することができます。焦点深度が深い像が得られることから、三次元的な画像が観察できる装置です。
走査電子顕微鏡は、タングステンフィラメントを電子源とする汎用的なもの(SEM)から、電界放出形電子銃を装着した高分解能・高倍率で観察が可能(FE-SEM)なものまで様々なタイプがあります。
弊社の特長
POINT
1精密機械製造メーカーで培った分析力を有しています。
原理と仕様
原理
走査電子顕微鏡(SEM)は、電子線を利用して試料表面の凹凸や形態を観察する顕微鏡です。光学顕微鏡とは異なり、電子線を試料表面に照射させ、発生した二次電子や反射電子を検出して、試料表面の微細形状と組成情報を観察できます。画像としては、数十倍~10万倍程度の観察が可能です。
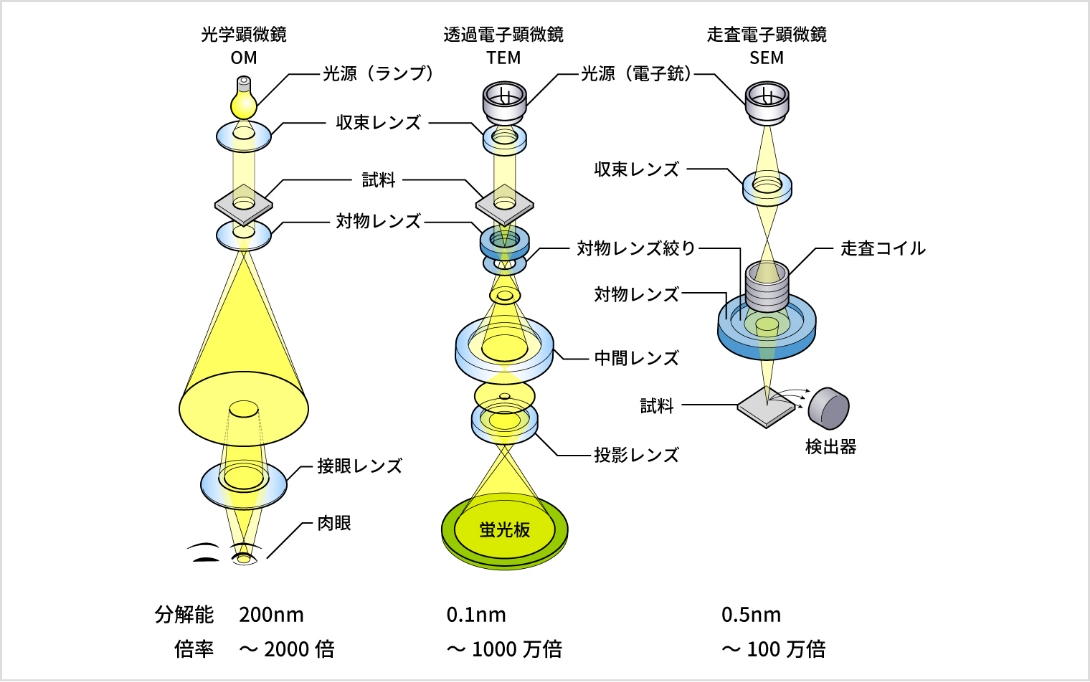
図1 TEMおよびSEMの構成と光学顕微鏡との比較
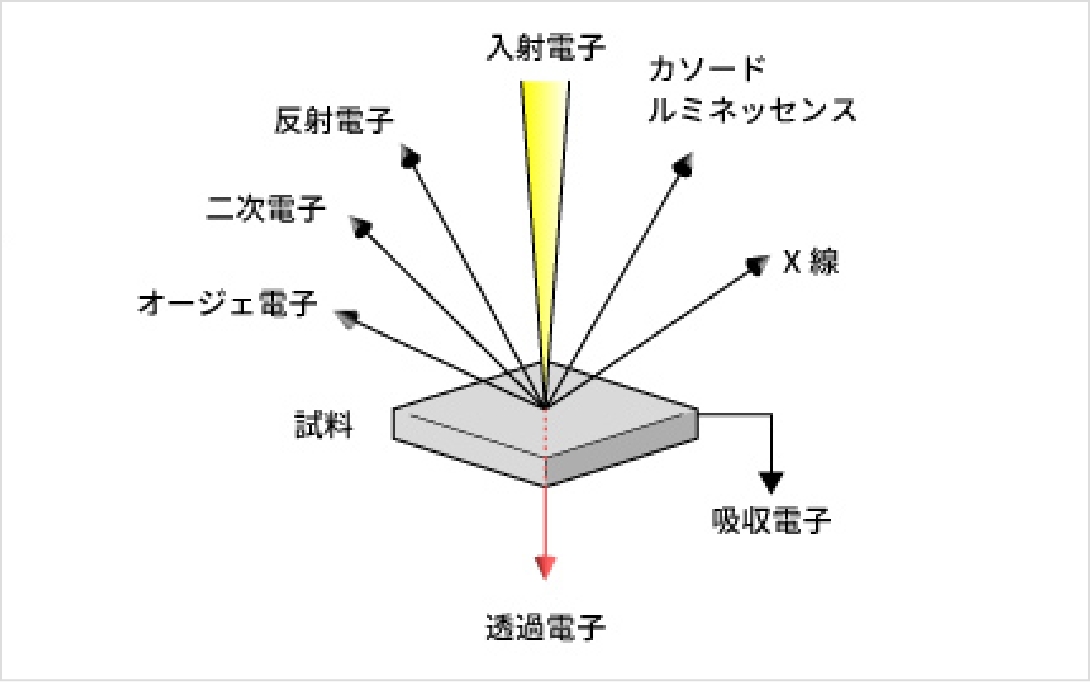
図2 物質から得られる各種情報
仕様
| 分解能 | 0.8 nm(15 kV) 1.2 nm(1 kV) 3.0 nm (15kV、5nA、WD10mm) |
|---|---|
| 倍率 | ×25~×1,000,000(SEM) |
| 加速電圧 | 0.01kV~30kV |
| X-Y | X:70mm、Y:50mm |
電子線後方散乱回折法(EBSD)
保有装置型式

Hikari Super TSL(EDAX)社製
特徴
微小領域での結晶粒径、相構造に関する
分析が可能
実装部などの微小部における残留応力の
評価が可能
- 50μm領域での残留応力測定実績あり
弊社の特長
POINT
1精密機械製造メーカーで培った分析力を有しています。
原理と仕様
原理

SEM チャンバー内にて結晶性試料を大きく傾斜し電子線を照射すると、右図のようにEBSD(Electron BackScatter Diffraction)パターンが発生します。このEBSD パターンを検出器により連続収集しながら、指数付けおよび結晶方位算出を行います。この連続した結晶方位データを用い、ミクロな材料組織の評価を行うことを目的に設計された専用のデータ解析ソフトウェアによってマップ・プロット・チャートなどに展開することが可能です。
仕様
| 試料サイズ | Φ32mm以内、高さ4mm以内 |
|---|---|
| 分析範囲 | 1μm~1mm程度、深さ50nm程度 |
| 分析機能 | 結晶粒径、結晶相構造、結晶方位解析 |
ダイヤモンドワイヤーソー
保有装置型式

多機能型ダイヤモンドワイヤーソー
(DWS 3500)
メイワフォーシス社製
特徴
多種のワイヤーを揃え、様々な微細加工に対応可能です。
透過X線装置の併用により、モールド樹脂品ような中身が見えないサンプルの位置指定加工も
可能です。
原理と仕様

10mのつなぎ目のないワイヤーを巻き取りドラムで往復させながら切断します。
ワイヤードラム1回転の送り量とねじピッチが精密に 計算された設計で、ドラム1回転ごとにねじが1ピッチ移動します。このため、ドラムの往復運動中もワイヤーの位置は常に定位置に維持されます。また、切断時の発熱が少ない利点を生かし、水の使用を避けたい試料や評価用の試料などを作製するケースでは乾式での切断にも対応可能です。
他の分析装置、前処理装置
X線CT装置
X線CT装置は、製品等の内部構造を非破壊で三次元的(立体的)に観察することが可能です。通常のX線透過装置とは異なり、様々な方向からX線で撮影し、再構成処理を行うことにより、三次元的(立体的に)観察することが可能です。
蛍光X線分析(XRF)
蛍光X線分析は、試料にX線を入射したとき、試料から放出される蛍光X線のエネルギー値を解析して、元素の種類を調べる方法です。 材料調査や有害規制物質(RoHS関連)のスクリーニング測定などに幅広く用いられています。
フーリエ変換赤外分光分析(FT-IR)
有機化合物および一部の無機化合物の分子構造、組成の解析を行い、主に未知試料の同定に用います。
顕微鏡ユニットで赤外光を絞り込み、微小試料の測定も可能です。
イオンスライサ
イオンスライサはArイオンを用いたTEM試料用加工装置です。
低エネルギーのArイオンを用いるためイオン注入によるダメージを抑えることができます。FIBにより作製した薄片試料に見られるアモルファス層などのダメージを除去することができ、高分解能観察に適した試料を作製することが可能です。
凍結切片作製用ウルトラミクロトーム
ウルトラミクロトームとは、ダイヤモンドナイフを用いてバルク材料を切削し、厚さ100nm以下のTEM観察用の超薄切片を作製する装置です。
加工面が平滑なためSEM観察やAFM観察も適しています。試料が軟らかく常温で薄切できない場合は、クライオミクロトームを用いて凍結下で加工することも可能です。
オスミウムコーター
導電性の無い試料に金属オスミウムの薄い被膜をコーティングするSEM観察の前処理装置です。
オスミウム雰囲気中でグロー放電を利用して、四酸化オスミウムの上記を分解し、コーティングを行います。粒状性が小さく、高倍率観察に適しています。