断面観察・断面分析
断面分析・断面観察(断面解析)は試料の構造、組成、故障解析のために、試料を断⾯加⼯し、試料内部の分析を⾏う⼿法です。
断⾯⽅向から観察や分析を⾏うことで、積層の構造や、接合界⾯の状態、その元素分布等を調べることができます。
断⾯作製⽅法として、機械研磨、イオンビーム加⼯が⽤いられます。
断面観察・断面分析の特徴
POINT
1イオンビーム加工は機械研磨法に比べて
試料へのダメージの少ない断面加工が可能です。
POINT
2冷却ステージにより
熱影響を低減した断面加工が可能です。
POINT
3高精度な断面加工による微小部の断面解析が可能です。
POINT
43次元的な構造解析が可能です。
断面観察・断面分析の手法
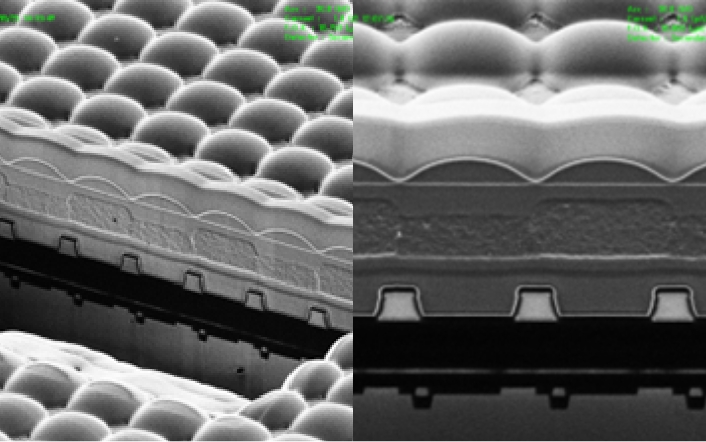
集束イオンビーム(FIB)
走査電子顕微鏡(FIB-SEM)観察
集束イオンビーム(FIB)により作製した断面をFE-SEMで高分解能観察を行う手法です。微小領域を高精度で断面加工・観察、および組成分析(SEM/EDS測定)を行うことが可能です。
また、連続して断面観察像を取得することで、3次元構造解析を行うことができます。

透過電子顕微鏡(TEM)観察
薄く加工した試料に電子線を照射し、透過、散乱した電子を結像して観察する手法です。
サブnmオーダーの高倍率観察や組成分析(STEM/EDS測定)が可能です。
また、試料を透過した電子の回折により得られた干渉像から結晶構造の解析にも用いられます。

断面 走査電子顕微鏡(SEM)観察
イオンミリング装置で試料の断面加工を行い、SEM装置で内部構造の観察、組成分析(SEM/EDS測定)、結晶方位測定(EBSD測定)を行う手法です。加工によるダメージが小さいので、試料の損傷を抑えて観察、各測定が可能です。また、冷却ステージにより、試料への熱ダメージを低減した加工も可能です。
断面観察・断面分析事例のご紹介
断面観察・断面分析に関するお問い合わせはこちらから
技術課題に対して現象把握~原因推定をお客様と一緒に考え、科学的な視点で調査することにより、原因究明や対策立案をサポートします。お気軽にご相談ください。
断面観察・断面分析設備の紹介

集束イオンビーム(FIB)
⾛査電⼦顕微鏡(FIB-SEM)
集束イオンビーム(FIB)により作製した断面をSEMで観察します。FIBとSEMが同一装置内にあるため、露出した断面を大気に触れさせることがなくSEM観察ができます。
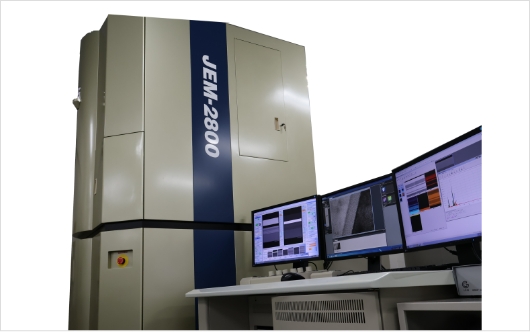
透過電子顕微鏡
(TEM、STEM、EDS)
電子線を試料に照射し、試料中を透過した電子を電磁レンズで結像し、高倍率で観察します。特に高分解能TEM法では、試料中を透過した電子と回折を起こした電子の両方を使って結像することで格子像の観察が可能です。

電界放出形走査電子顕微鏡
(FE-SEM)
微小な表面構造を鮮明に観察することができます。試料をイオンミリングなどで断面を作成して観察します。観察焦点深度が深い像が得られることから、三次元的な画像が観察できる装置です。
断面観察・断面分析に関するお問い合わせはこちらから
技術課題に対して現象把握~原因推定をお客様と一緒に考え、科学的な視点で調査することにより、原因究明や対策立案をサポートします。お気軽にご相談ください。