XRF-薄膜FP法による膜厚測定

| 背景 | 蛍光X線分析(XRF)による非破壊での膜厚測定法は広く知られていますが、分析対象試料と標準試料の間で組成や密度の違いがあると測定結果に影響を及ぼします。 今回、参照試料を用いて膜厚測定を行うXRF-薄膜 FP 法について紹介します。 |
|---|
分析事例
XRF-薄膜FP法による膜厚測定
■背景
蛍光X 線分析(XRF)による非破壊での膜厚測定法は広く知られていますが、分析 対象試料と標準試料の間で組成や密度の違いがあると測定結果に影響を及ぼします。今回、参照試料を用いて膜厚測定を行うXRF-薄膜FP法について紹介します。
■分析ステップ
1. 参照試料の分析(実測)・鋼板に施されたニッケルめっきの例です。
・XRF-薄膜FP法では、まず参照試料の情報を断面観察法により獲得します。
・FIB断面観察像を図1に示します。ここから情報として層数、組成、膜厚値を解析します。
・参照試料は分析対象試料と同一のプロセスで作製した試料とすることができます。また、分析対象試料の一部を使うこともできます。
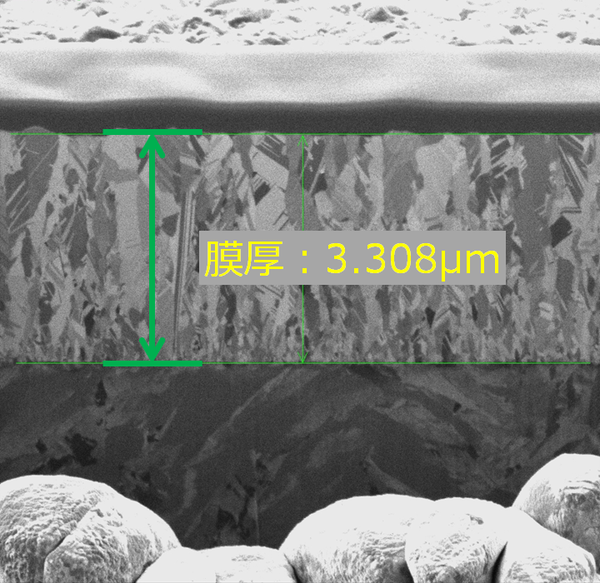
図1.FIB断面観察像
2. 参照試料のXRF分析・XRFで参照試料の定性スペクトルを取得して上記1.で獲得した情報との紐づけを行います。
・XRFスペクトルデータを図2に示します。

図2.XRF定性スペクトルデータ
・薄膜FP法で対象試料の測定を実施すると上記2.を基にした膜厚値が算出されます。
■結果
- 分析対象試料の測定結果を表1に示します。
- 本測定法とFIBでの断面観察法とでは測定値の誤差が非常に小さいことが分かります。
表1.XRF-薄膜FP法とFIB断面観察による測定結果(断面観察による実測値との比較)

■特徴
- XRF-薄膜FP法では分析対象試料と同一のプロセスで作製した参照試料を使うことができます。
- 分析対象試料と参照試料はめっきの密度や組成が同等であることからXRF-薄膜FP法の測定結果は高い精度になります。
- 理論計算に基づいて膜厚値を算出するため、多層膜や合金膜の膜厚測定にも適用可能です。
本事例の資料は上部『詳細PDFをダウンロード』ボタンでダウンロード可能です
受託分析・微細加工(FIB加工)のご依頼について
技術課題に対して現象把握~原因推定をお客様と一緒に考え、科学的な視点で調査することにより、原因究明や対策立案をサポートします。お気軽にご相談ください。