STEM/EDSによる半導体絶縁膜評価
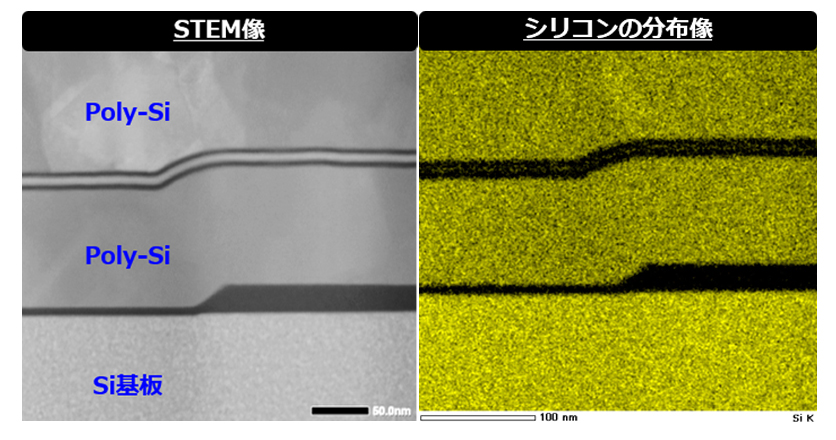
| 目的 | 半導体のPoly-Siおよび絶縁膜の評価を行う |
|---|---|
| 手法 | 透過電子顕微鏡(STEM/EDS) |
| 手法の特徴 | ・半導体デバイスでの指定部位観察が可能 ・STEM-EDSにより高倍率観察・高分解能分析が可能 |
| 結果 | ・STEM観察によりPoly-Siおよび絶縁膜の形状に異常が無いことが確認できた ・EDS分析によりPoly-Si間の絶縁膜(Si酸化膜-Si窒化膜-Si酸化膜)の層構造も問題ないことが確認できた |
分析事例
STEMおよびEDSによる半導体絶縁膜の評価(断面観察と分析)
- FIBで半導体デバイスの指定部位での試料を作製できます
- STEMおよびEDSにより高倍率観察・高分解能分析が可能です
■半導体Poly-Si間の絶縁膜分析
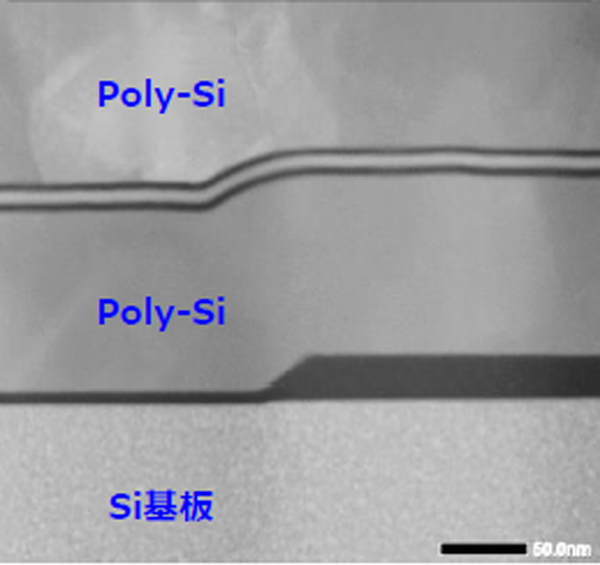
STEM像
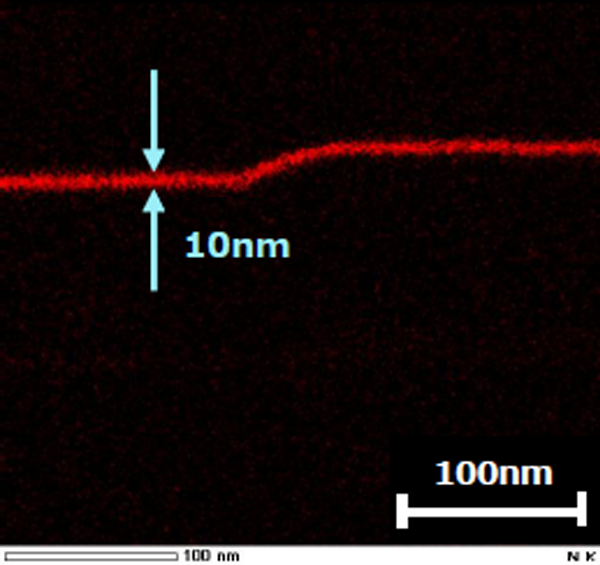
窒素の分布像
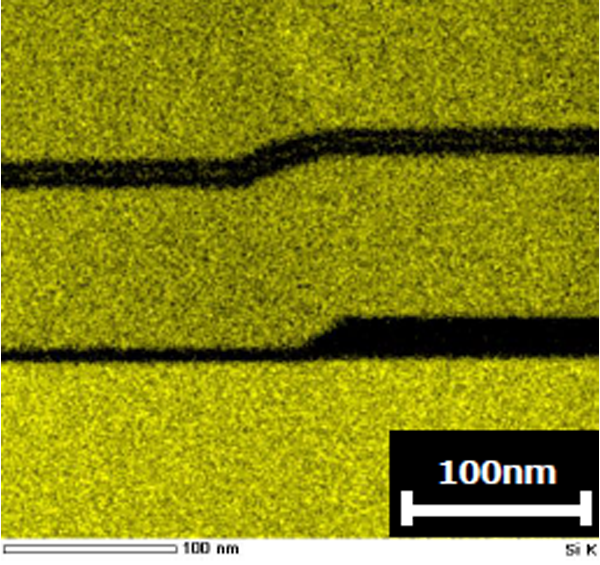
シリコンの分布像
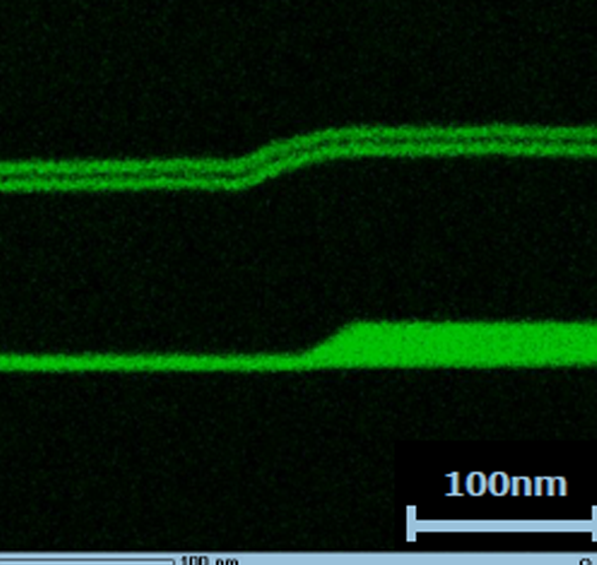
酸素の分布像
■解析結果
- STEM観察によりPoly-Siおよび絶縁膜の形状に異常が無いことが確認できました
- EDS分析によりPoly-Si間の絶縁膜(Si酸化膜/Si窒化膜/Si酸化膜)の層構造も問題ないことが確認できました
本事例の資料は上部『詳細PDFのダウンロード』ボタンでダウンロード可能です
受託分析・微細加工(FIB加工)のご依頼について
技術課題に対して現象把握~原因推定をお客様と一緒に考え、科学的な視点で調査することにより、原因究明や対策立案をサポートします。お気軽にご相談ください。