FIBによるめっき層内の異常個所発見方法
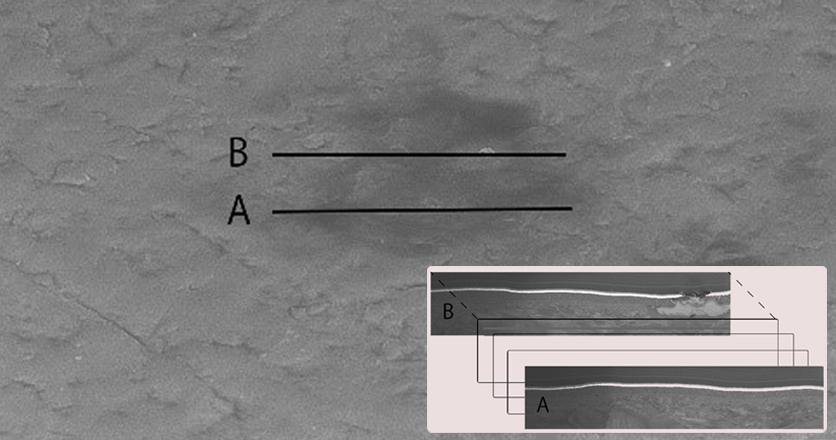
| 目的 | めっき層内の表面からでは分からない異常個所を発見する |
|---|---|
| 手法 | FIB-SEMの連続自動断面作製および観察昨日(Slice&View)を用いる |
| 結果 | 断面を狭ピッチで連続して作成し観察することで内部の異常個所を特定し、変色の原因が内部の異常であることが判別できた |
測定データ
FIB装置では、自動で断面を連続で作製し、断面写真を取得することが可能です。この機能を用いて、表面からでは判別が難しい試料内部に存在する異常個所を特定することが可能です。写真1は、変色の発生しためっき被膜の表面SEM写真です。表面からの様子では内部の異常個所を特定することが難しい場合が多いため、変色の原因が外部からの付着によるものか内部の異常によるものかの判別が困難です。このようなケースでは、写真2のラインAからラインBに向かって連続で断面を作製することで、内部の様子を確認する手法が有効です。

写真1:めっき被膜表面SEM写真

図1. 断面加工・観察イメージ
写真1の例ではラインAからラインBに向かって連続で100か所の断面を作製し、それぞれの断面写真を撮影しました。加工・観察は装置が自動で行います。断面から断面へのピッチも指定可能です。
写真2-Aは、ラインAにおける断面写真です。断面写真で白くはっきり見えている部分が、最表面のめっき層となります。ラインAでは試料内部に異常は見られませんでした。
写真2-Bは、ラインBにおける断面写真です。
ラインBでは写真右側に、試料内部に空隙が発生して大きく拡がっている様子が確認できます。
内部の空隙に比べ最表面のめっき層の損傷が小さかったため、表面からの観察では内部の異常個所を判別できませんでした。が、断面を狭ピッチで連続して作製し、観察することで内部の異常個所を特定し、変色の原因が内部の異常であることが判別できました。

写真2-A. ラインAの断面SEM写真

写真2-B. ラインBの断面SEM写真
加工・観察のご提案
- FIB装置による連続自動断面作製・観察の活用例として、試料内部の異常個所の発見方法を紹介しました。
- 一つの異常個所に対して、多くの連続した断面写真を取得することは、異常個所を立体的に把握する手法としても有効です。
- 得られた断面写真から3D画像を構築したり、アニメーションを作製するなど、様々な活用方法が考えられ、今まで以上に断面観察から多くの情報を得られることが期待できます
受託分析・微細加工(FIB加工)のご依頼について
技術課題に対して現象把握から原因推定をお客様と一緒に考え、科学的な視点で調査することにより、原因究明や対策立案をサポートします。お気軽にご相談ください。