赤外顕微鏡(FT-IR装置)によるシリコン膜厚測定

| 目的 | シリコン薄膜の膜厚測定 |
|---|---|
| 手法 | 赤外顕微鏡によるピンポイントでの反射測定、および膜厚換算 |
| 結果 | 非破壊でシリコン薄膜の厚みを測定、断面観察結果と同等の結果を獲得 |
分析事例
赤外顕微鏡(FT-IR装置)によるシリコン膜厚測定
- 目的:シリコン薄膜の膜厚測定
- 手法:赤外顕微鏡によるピンポイントでの反射測定、および膜厚換算
- 結果:非破壊でシリコン薄膜の厚みを測定、断面観察結果と同等の結果を獲得
■原理
基板表面(上面)並びに裏面(下面)から反射して得られた2つの光線の干渉波ピーク間隔から薄膜の厚みを求めます。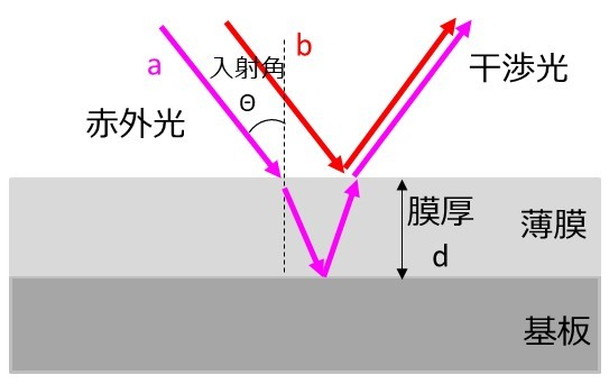

図1.薄膜試料の断面イメージ
■測定
赤外顕微鏡の反射測定により干渉波形を測定し、膜厚を算出しました。また、断面SEM観察法により同サンプルのシリコン膜厚比較を行いました。
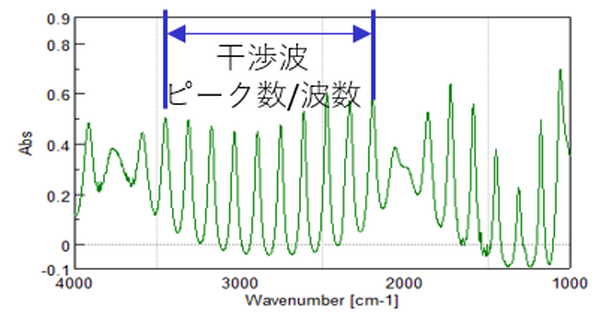
図2.赤外光の反射スペクトル
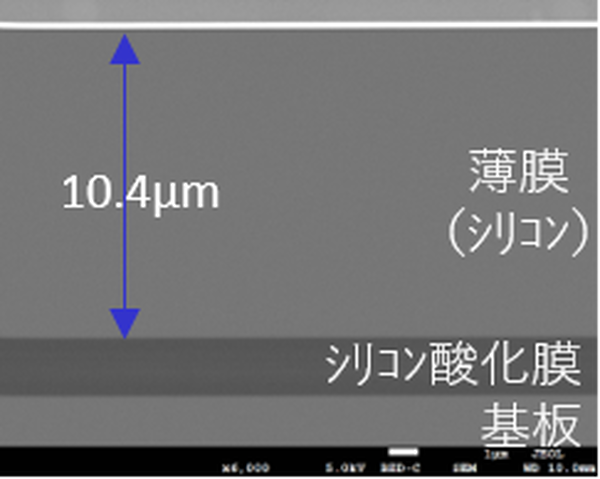
図3.断面SEM観察像

表1.赤外顕微鏡測定と断面SEM観察による膜厚の比較(μm)
■まとめ
- 赤外顕微鏡の反射測定により、シリコン薄膜の膜厚をピンポイント(数十μm角)で非破壊測定することができました。
- 比較測定の断面SEM観察法の測定結果とも近い値を示しています。
本事例の資料は上部『詳細PDFをダウンロード』ボタンでダウンロード可能です
受託分析・微細加工(FIB加工)のご依頼について
技術課題に対して現象把握~原因推定をお客様と一緒に考え、科学的な視点で調査することにより、原因究明や対策立案をサポートします。お気軽にご相談ください。