AFM表面測定及びFIB断面観察による構造解析
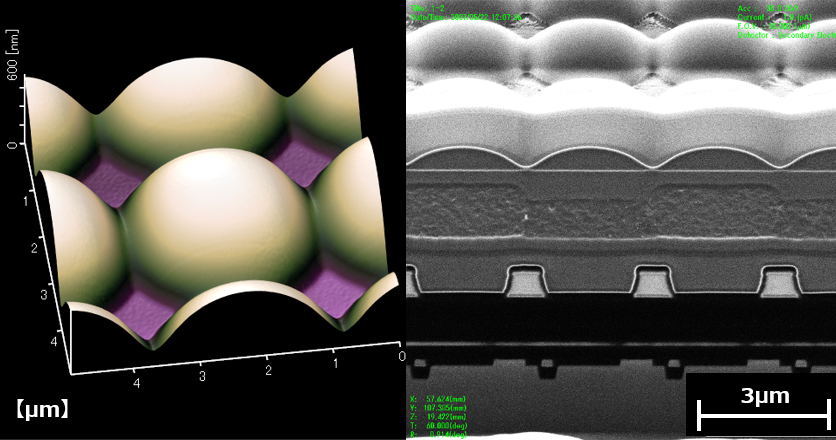
| 目的 | 多面的に構造解析を行い多種多用の情報を獲得する |
|---|---|
| 手法 | ・AFMによるナノレベルの三次元的解析 ・FIBによる試料内部の多層構造観察 |
| 結果 | AFMの三次元像とFIBの断面観察像から多くの情報を取得 |
分析事例
AFM表面測定及びFIB断面観察による構造解析
- 本事例では半導体ICとレンズからなるデバイス(カメラ)を分析します
- 多面的な構造解析を行い多種多様の情報を獲得します
- AFMによるナノレベルの三次元的解析を実施
- FIB による試料内部の多層構造を観察
■マイクロカメラ(レンズおよびCMOSイメージセンサ)の構造解析
- 試料はレンズおよびCMOSイメージセンサからなるマイクロカメラです
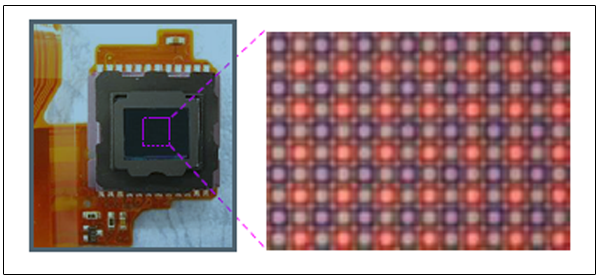
試料外観
- AFMで表面形状が分かる3次元像を取得しました。高さも定量的に把握できています
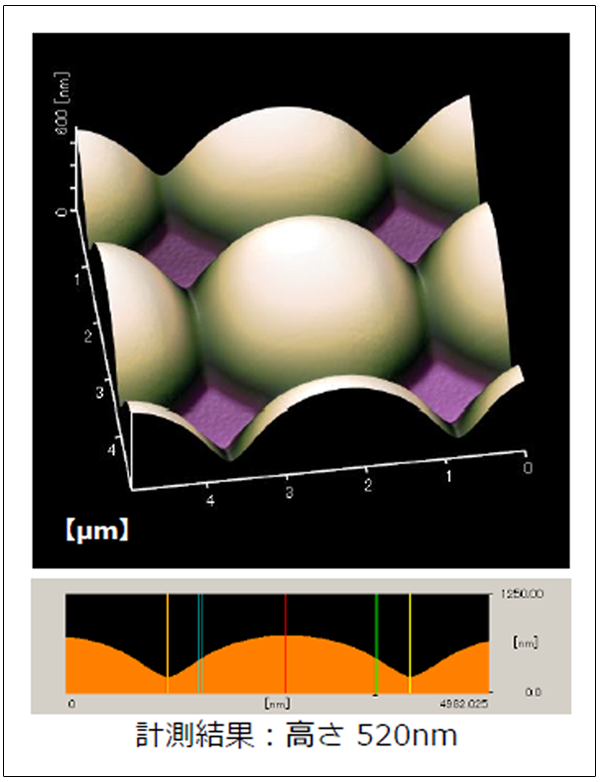
CMOSイメージセンサのAFM三次元像
- FIBでイメージセンサ断面を露出させるための加工をしました。目的の場所を狙えます
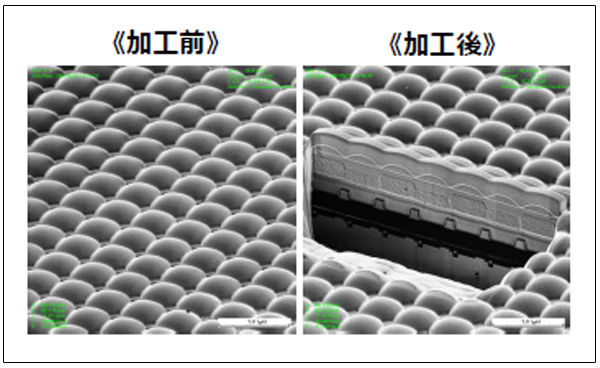
FIBによる加工の様子
- FIBで断面の観察をしました。断面がはっきりと見え各部のサイズも確認できます
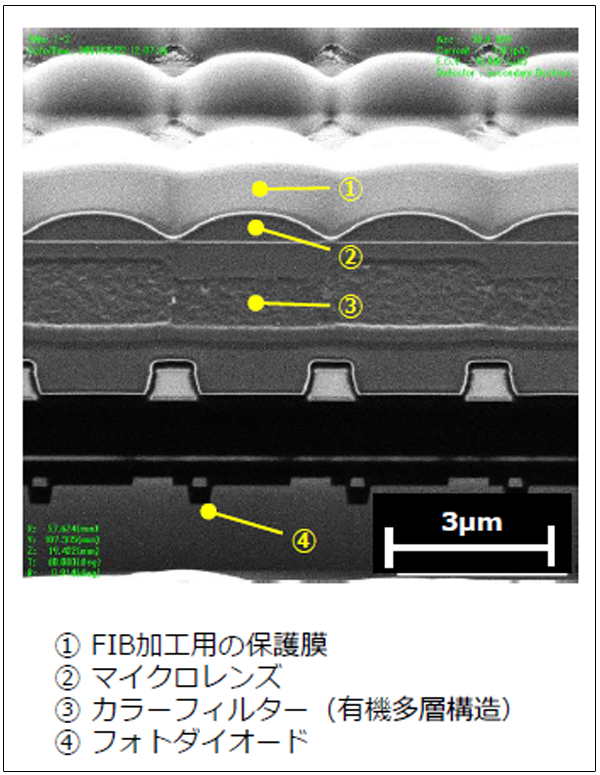
FIB断面観察像
■観察および解析結果
- AFMの三次元像とFIBの断面観察像から多くの情報を取得できました
- 本事例のように機器分析装置を駆使して半導体をはじめ電子部品他各分野の製品を多面的、多角的に観察に分析、そして解析を実施できます
本事例の資料は上部『詳細PDFのダウンロード』ボタンでダウンロード可能です
またFIBの『Slice & View』でより詳しい観察が可能です。こちらをぜひご覧ください
受託分析・微細加工(FIB加工)のご依頼について
技術課題に対して現象把握~原因推定をお客様と一緒に考え、科学的な視点で調査することにより、原因究明や対策立案をサポートします。お気軽にご相談ください。